导热材料主要用于提升热传导中的导热和均热效率。元器件沿其材料表面的两个方向的均匀导热性能通常有限,所以需要使用水平方向上具有较高导热率的材料将局部高温向四周扩散。而不同元器件之间,由于界面之间直接接触存在凹凸不平的空隙,会产生热阻(空气的导热效率非常低),因此需要使用导热界面材料填充空隙,以便于热量更快地在不同界面间传导。导热材料分类繁多,不同的导热材料有不同的特点和应用场景。目前广泛应用的导热材料有导热硅胶垫片、导热凝胶、导热硅脂、导热结构胶、导热填隙材料等。下文将带大家了解导热材料如何带动技术发展和产业升级。

一、导热材料的概念
导热材料是一种用在热传导路径上提高散热性能的材料。它通常位于电子设备中,如处理器、电源设备、电路板等热源与散热器之间,从而确保系统设备运行时保持在可接受的温度水平,最终保障系统的可靠性、性能和寿命。导热材料主要作用是提升热传导中的均热和导热效率。元器件沿其材料表面的两个方向的均匀导热性能通常有限,所以需要使用水平方向上具有较高导热率的材料将局部高温向四周扩散。而不同元器件之间,由于界面之间直接接触存在凹凸不平的空隙,会产生热阻的空气导热效率非常低,因此需要使用导热材料填充空隙,以便于热量更快地在不同界面间传导。
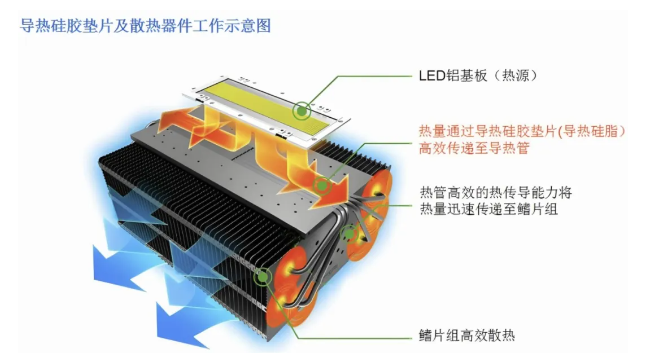
二、导热材料的分类及其应用
导热材料种类众多,目前市场上最常用的分类是根据导热材料的应用场景和形态性质来分,主要包括石墨散热膜、导热散热材料(热管、均热板等)和导热界面材料(如导热硅脂、导热凝胶等)。常见的导热材料的特点以及其应用领域如下图:

三、导热材料的产业链及应用场景
导热材料应用集中在消费电子、动力电池、芯片半导体等领域,产业链图谱如下图:
 消费电子
消费电子
智能手机、平板电脑等无主动散热设备通常采用石墨系材料/均热板与硅脂/硅胶片的组合来处理散热。在大部分主流安卓智能手机和平板电脑中,均热板被用作散热元件,而均热板与芯片之间的空隙则使用硅脂填充。苹果公司的手机和平板产品由于其软硬件构架适配性较高,目前最新产品仍然采用合成石膜和硅脂作为芯片外导热结构,尚未采用均热板。
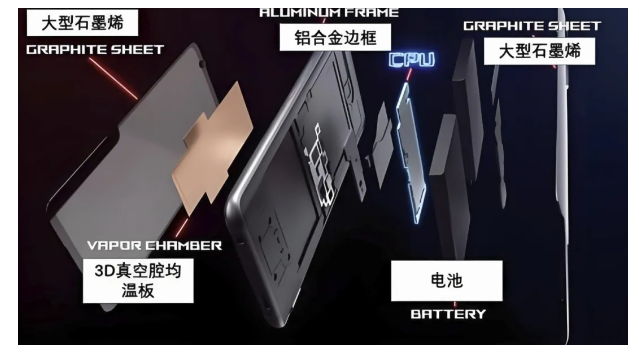
而对于需要主动散热的设备,如个人电脑(PC)、服务器、计算中心和基站等高能耗设备,首选的芯片外导热材料是热管+硅脂。这些设备通常配备了风冷或水冷等散热模块,均热或导热段的主要作用是将热量传导到散热模块处,然后通过热风或热水将热量带走。因此,5G基站对导热材料的导热系数要求接近10W/m·K,而计算中心和基站可能需要更高的导热性能。在这样的需求驱动下,大部分需要主动散热的设备选择热管来实现热量的定向传导,并使用硅脂填充间隙。少数高端个人电脑和最新型的基站也可能选择VC(石墨烯复合材料)或相变金属作为导热材料。
 汽车电子
汽车电子
电池系统中常用的导热材料是聚氨酯导热结构胶。在动力电池行业,选择导热胶时需要综合考虑导热性能、再粘接性能、轻量化、低成本和挥发性等因素,因此导热性能通常保持在1.2-2.0 W/m·K范围内。由于电池厂商对导热胶的需求量大且不断降低成本,无法选择导热性能较高(>3.0W/m·K)的有机硅产品,因此具有优势的聚氨酯导热结构胶成为了许多电池厂家的选择。
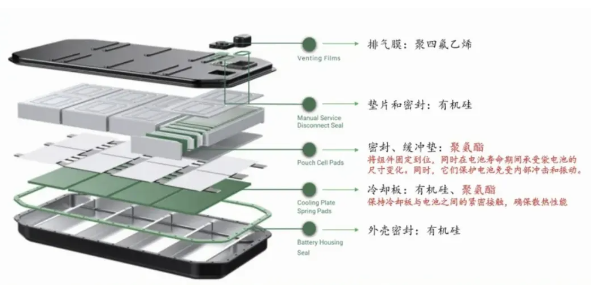
另外,导热硅胶是一种片状固体材料,主要用于较小发热量的电子零件和芯片表面,也广泛用于动力电池组。导热硅胶可涂覆在各种电子产品和电器设备中,用于发热体与散热设施(如散热片、散热条、壳体等)之间的接触面,起到传热媒介、防潮、防尘、防腐蚀和防震等作用。
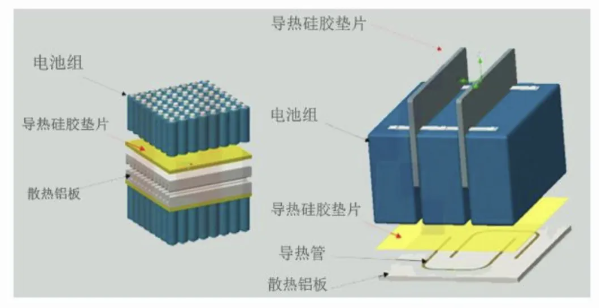 芯片封装
芯片封装
导热材料在芯片中起着重要的作用,主要分为内部导热材料和外部热管理材料两部分。它们的区别在于是否封装在芯片内部。芯片的内部导热材料包括封装基板、底填材料和热界面材料(TIM)。这些材料主要用于芯片内部的热传导和散热。封装基板提供了芯片的物理支撑和电路连接,并且通常具有良好的导热性能。TIM 材料一般选用硅脂或硅胶片。底填材料用于填充芯片底部,提高散热效果。热界面材料(TIM)则用于填充芯片和散热器之间的微小间隙,以提高热传导效率。
芯片外部的导热材料根据不同设备使用的芯片而有所不同。智能手机和平板电脑等主要依靠被动散热的设备通常使用石墨系材料(主要是合成石墨膜)和导热胶(VC)等材料。而需要主动散热组件(如风冷、水冷器件)的个人电脑和服务器等设备,则主要使用热管和导热胶(VC)等材料来增强散热效果。
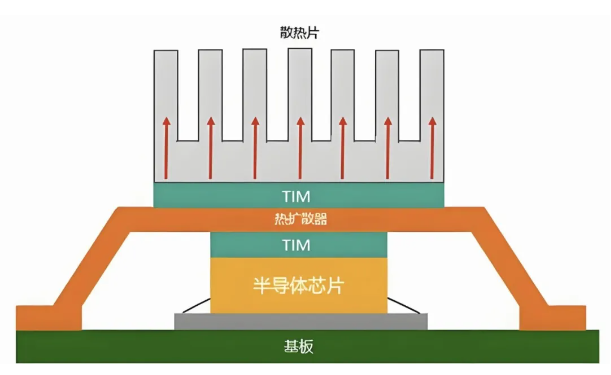
典型芯片中的导热材料分为芯片内部的导热材料和顶部与底部的连接材料。在芯片封装过程中,这些连接部位的空隙会影响传热性能,因此需要适当的热界面材料(TIM)满足芯片与封装壳和芯片与基板之间的传热需求。底部连接材料通常采用环氧树脂基材料,用于连接芯片底部与基板。底部填充材料用于填充芯片与基板之间的焊球间隙。常见的底部填充胶是由硅树脂基体和二氧化硅填充物组成的环氧树脂。环氧树脂的热固性和生产过程的便捷性使其成为主要选择。
顶部连接材料一般采用硅脂和无机相变金属材料(主要是铟)。顶部导热材料用于填充芯片与封装外壳之间的空隙。在芯片中,常用的封装材料包括聚氨酯、环氧树脂、硅橡胶或凝胶等。目前,硅脂是常用的顶部填充材料,使用简便,只需在裸芯片顶部涂覆硅脂,然后放置封装外壳。在一些高端个人电脑的中央处理器(CPU)中,也开始使用无机相变材料作为顶部连接材料。
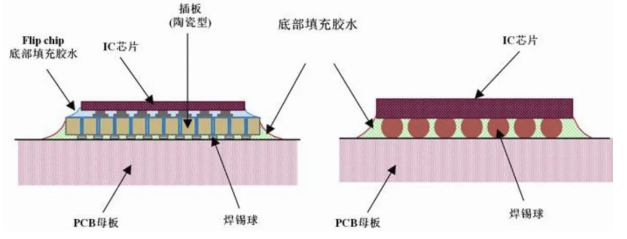
导热材料产业的发展历程十分悠久,其商业化历程可以追溯到上世纪50年代,当时主要使用金属铝和铜作为导热材料;随着人工智能、5G等新兴技术的发展,我们可以期待未来会有更多具有高导热效率的新型材料问世,以满足不断增长的市场需求,并提高电子设备的性能和可靠性。