垂直排列结构的碳纤维基热界面材料
年来,半导体技术突飞猛进,推动硅基芯片向更精确的制造工艺和创新的三维芯片堆叠技术发展,同时氮化镓(GaN)、碳化硅(SiC)等第三代半导体新材料不断涌现,广泛应用于5G基站、超快充电站、消费电子等领域。工艺和新材料的进步提高了芯片的性能,但也导致了显著的散热问题。散热不足会影响电子设备在使用过程中的可靠性和稳定性,潜在地威胁到它们的使用寿命为了控制芯片的工作温度,确保从芯片到散热器的有效传热是解决这一挑战的关键一步。热界面材料(TIMs)已被开发用于桥接芯片和散热器之间的配合界面,消除空气间隙并增强它们之间的有效传热。理想的TIMs不仅具有高的通平面导热系数,而且与加热器和散热器具有低的接触热阻一般来说,低接触热阻的TIMs要求可压缩性和弹性,以确保在正常封装条件下配合表面之间有更大的有效接触面积。由于其灵活性,独特的设计自由度和成本效益,聚合物已成为最常见的TIMs的主要基质。然而,聚合物的低导热性,由于其无定形排列和分子链振动,限制了它们在热管理中的直接应用。近日,中国科学院宁波材料技术与工程研究所虞锦洪、江南团队联合中国宁波诺丁汉大学Li Nan针对开发具有高导热性和最小热阻的热界面材料(TIMs)来有效解决电子器件散热挑战取得最新进展。该文提出了一种新型的夹层结构,将垂直传热途径与表面改性相结合。该结构的核心是垂直排列的CF复合材料,通过滚压方法获得,两侧是液态金属改性层,以减少接触热阻。在填料含量为73.68 wt%的情况下,复合材料的通平面导热系数为51.90 W/mK,比PDMS基体高323倍,界面改性后总热阻从0.55降至0.32 K cm2 /W。这项研究为设计用于增强热管理的cf基复合材料提供了见解,适用于云计算和自动驾驶。研究成果以“Enhanced thermal conductivity and reduced thermal resistance in carbon fiber-based thermal interface materials with vertically aligned structure”为题发表在《Journal of Materials Chemistry A》期刊。

图1.VCB TIMs的制备及形貌研究。
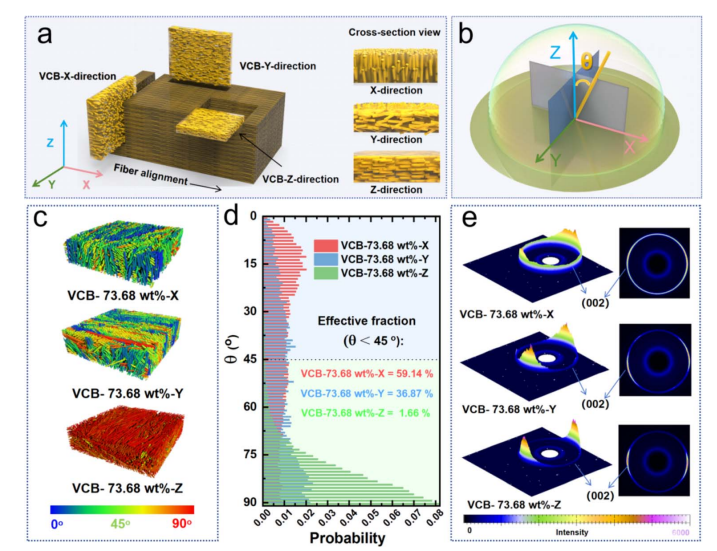
图2.VCB复合材料的微结构表征。

图3.VCB复合材料的热性能。

图4. 压力对VCB 73.68 wt%-X复合材料导热性和结构的影响。
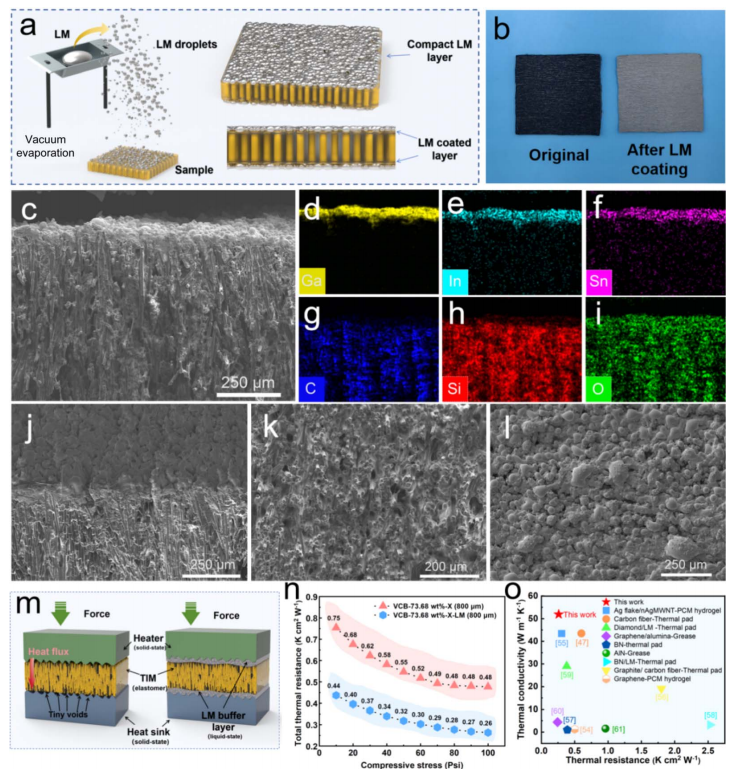
图5.功能化涂层的制备与表征。

图6.VCB复合材料的TIM性能及热管理论证。